應用領域
| Market | Application | Related Product | Features | ||
|---|---|---|---|---|---|
| Probe Technology | KI Model | ||||
| Memory Test | NAND Flash | High Density Memory | MEMS | Cygnus |
Full Wafer Contact for 12" Wafer Up to 2,000 DUT / 62,000 Pins Utilizing MEMS Probes 1.2A C.C.C. -40℃ ~ 125℃ Operating Temp. |
| DRAM / HBM | Ultra High Density Memory | MEMS | Orion |
Full Wafer Contact for 12" Wafer Up to 2,500 DUT/ 150,000 Pins Utilizing MEMS Probes 1.0A C.C.C. -40℃ ~ 105℃ Operating Temp |
|
| Logic Test | SoC | Fine-Pitch Logic Device (AP, CPU, GPU, ASIC, FPGA, MCU, Connectivity) |
MEMS Vertical | Taurus |
MEMS Probe Min. 70㎛ Pitch Full array Up to 8 DUT / 50,000 Pins+ C.C.C. : > 0.8~2.5 A Probe Force can be customized Space Transformer (MLC, MLO, Cu wire) utilized |
| CIS | High performance Imaging | MEMS CIS | Sirius |
Up to 64 DUT+ Image Test All DUT Characteristic Uniformity Min. 60㎛ Pad Pitch >20 Gbps Short Scrub mark |
|
| DDI, MCU, Smart Card | Conventional & Cost-effective | Cantilever-Needle | Cantilever |
Pitch : Fine pitch & Multi-DUT Min. Pitch : DDI ( 12.5/25μm, 23μm) SoC (50μm) Min. Pad Size : DDI (13X30μm) SoC (40X40μm) Test Temp : -25℃ ~ 125℃ |
|
| DC Parametric | Wafer level leakage DC Test | MEMS / Cantilever | DC Para |
Min. 60um pad pitch Low leakage DC Test (Under 500fA leakage) -20~125 ℃ Operating Temp. Easy Repair Small pad contact (Pad size: 35um x 35um) |
|
應用領域與 KI 產品示例
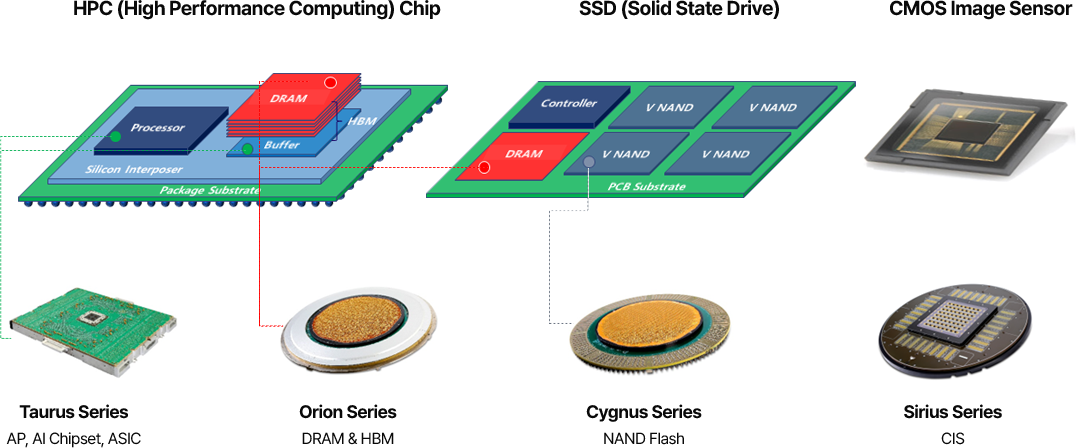
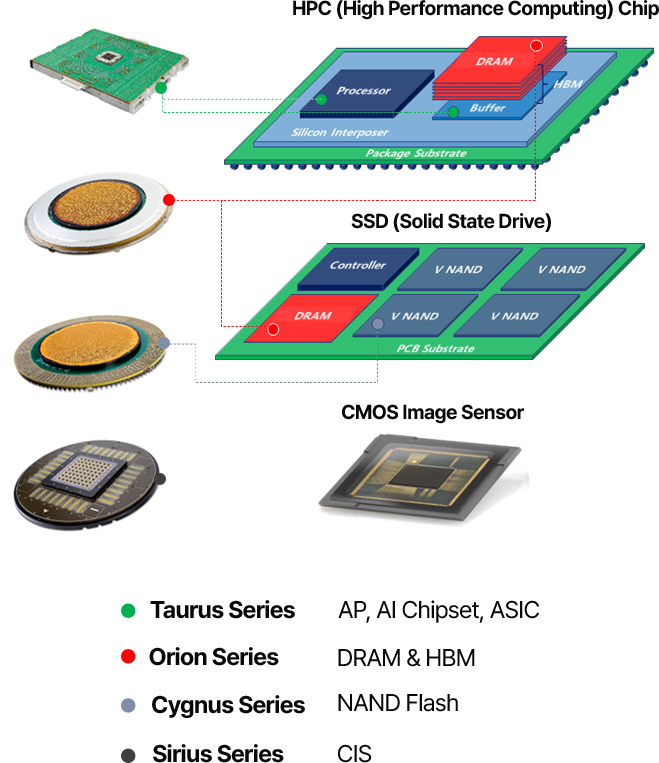
記憶體晶片
隨著記憶體元件的高速發展與資料量呈指數型成長,市場對 DRAM 與快閃記憶體的需求持續攀升。
同時,記憶體 IC 技術朝向高密度與多樣化發展,使半導體製造商面臨平行測試與全晶圓接觸等關鍵挑戰。
透過 KI 的高效能晶圓測試解決方案,晶片製造商得以提升良率、降低整體測試成本,並有效縮短下一世代記憶體產品的上市時程。
邏輯晶片
隨著人工智慧(AI)、高效能運算(HPC)、車用電子與行動裝置的快速發展,半導體技術正面臨前所未有的演進挑戰。 在元件持續微縮與高度整合的趨勢下,市場對高可靠度測試解決方案的需求顯著提升,尤其在更細間距、更高載流能力與更佳機械耐用度方面。
為因應這些挑戰,KI 的邏輯晶圓探針卡致力於提供次世代半導體測試所需的精準度與效率。
System on Chip (SoC)
隨著 AI、高效能運算(HPC)與消費性電子產品的發展,次世代邏輯技術正持續演進。
KI 的晶圓探針卡可因應不斷提升的測試挑戰,提供高精準度與高效率的測試解決方案。
CMOS Image Sensor (CIS)
CMOS 影像感測器的技術發展趨勢, 包含更高解析度、更高感光度、更高速讀取、 更高整合度,以及 3D 感測與 AI 功能整合。
KI 的 CIS 探針卡為 CMOS 影像感測器測試 提供高度客製化的解決方案。
Display Driver IC (DDI)
顯示驅動 IC(DDI)的技術發展趨勢,涵蓋高效能、低功耗、多通道化與功能整合。
KI 自 DDI 技術初期即持續投入研發,在支援現有應用的同時,也積極布局下一世代 DDI 技術。