应用领域
| Market | Application | Related Product | Features | ||
|---|---|---|---|---|---|
| Probe Technology | KI Model | ||||
| Memory Test | NAND Flash | High Density Memory | MEMS | Cygnus |
Full Wafer Contact for 12" Wafer Up to 2,000 DUT / 62,000 Pins Utilizing MEMS Probes 1.2A C.C.C. -40℃ ~ 125℃ Operating Temp. |
| DRAM / HBM | Ultra High Density Memory | MEMS | Orion |
Full Wafer Contact for 12" Wafer Up to 2,500 DUT/ 150,000 Pins Utilizing MEMS Probes 1.0A C.C.C. -40℃ ~ 105℃ Operating Temp |
|
| Logic Test | SoC | Fine-Pitch Logic Device (AP, CPU, GPU, ASIC, FPGA, MCU, Connectivity) |
MEMS Vertical | Taurus |
MEMS Probe Min. 70㎛ Pitch Full array Up to 8 DUT / 50,000 Pins+ C.C.C. : > 0.8~2.5 A Probe Force can be customized Space Transformer (MLC, MLO, Cu wire) utilized |
| CIS | High performance Imaging | MEMS CIS | Sirius |
Up to 64 DUT+ Image Test All DUT Characteristic Uniformity Min. 60㎛ Pad Pitch >20 Gbps Short Scrub mark |
|
| DDI, MCU, Smart Card | Conventional & Cost-effective | Cantilever-Needle | Cantilever |
Pitch : Fine pitch & Multi-DUT Min. Pitch : DDI ( 12.5/25μm, 23μm) SoC (50μm) Min. Pad Size : DDI (13X30μm) SoC (40X40μm) Test Temp : -25℃ ~ 125℃ |
|
| DC Parametric | Wafer level leakage DC Test | MEMS / Cantilever | DC Para |
Min. 60um pad pitch Low leakage DC Test (Under 500fA leakage) -20~125 ℃ Operating Temp. Easy Repair Small pad contact (Pad size: 35um x 35um) |
|
应用领域 & KI 产品示例
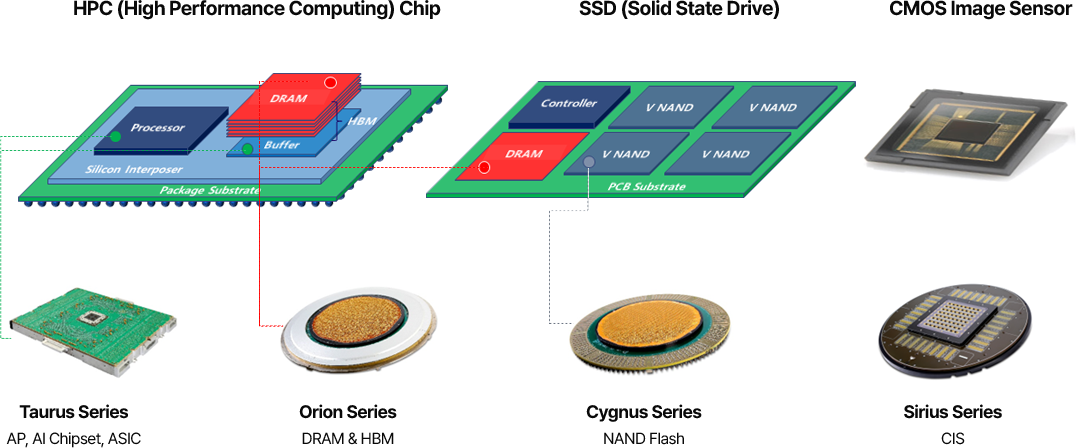
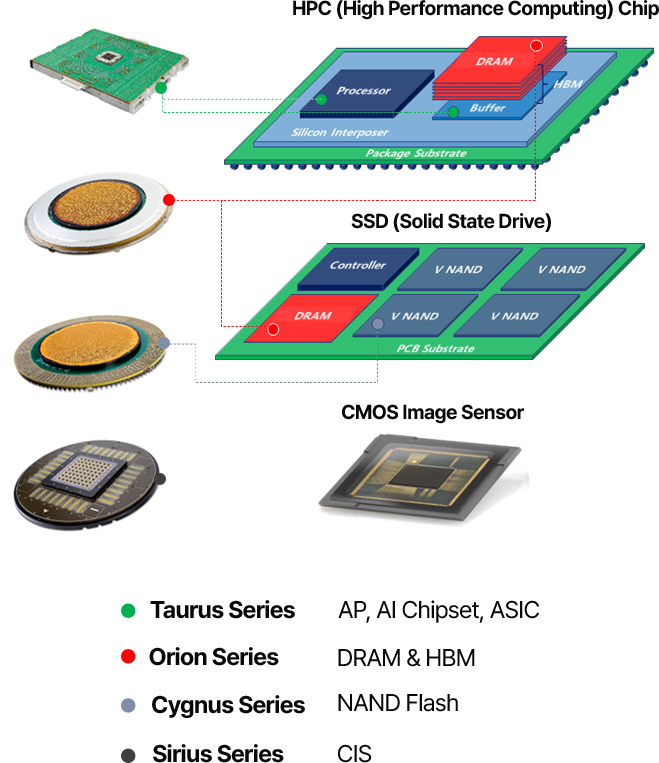
存储器芯片
存储器器件的快速扩散以及数据的指数级增长,正在推动对 DRAM 与闪存的强劲需求。随着存储器 IC 技术不断扩展与多样化,半导体制造商正面临高并行测试与全晶圆接触等关键挑战。借助 KI 的高性能晶圆测试解决方案,芯片制造商可优化良率、降低整体测试成本,并缩短下一代存储器器件的上市周期。
逻辑芯片
受人工智能(AI)、高性能计算(HPC)、汽车技术与移动设备发展的推动,半导体技术正面临重大的演进挑战。随着设备更小、更强并互联,对可靠测试解决方案的需求也显著增加,尤其体现在探针针脚的更细间距、更高载流能力与更强机械耐久性方面。
为解决这些问题,KI 的逻辑晶圆探针卡旨在提供下一代半导体测试所需的精度与效率。
System on Chip (SoC)
随着 AI、HPC 与家电产品的发展,下一代逻辑技术正在演进。
KI 的晶圆探针卡为应对不断演进的测试挑战提供精度与效率。
CMOS Image Sensor (CIS)
CMOS 图像传感器的演进方向包括:更高分辨率、更高灵敏度、更高速、更高集成度、3D 感知以及 AI 功能集成。
KI 的 CIS 探针卡为 CMOS 图像传感器测试提供定制化解决方案。
Display Driver IC (DDI)
DDI(显示驱动芯片)的演进方向包括:更高性能、更低功耗、多通道化以及功能融合。
KI 从 DDI 早期至今一路参与技术演进,在应对传统技术的同时,也在共同准备下一代 DDI 的到来。